碳化硅(SiC)单晶材料作为第三代半导体材料的代表,具有禁带宽度大、击穿电场高、热导率高、电子饱和迁移率高及 抗辐射能力强等优越性能,既可以满足功率器件对耐高温、大功率、高电压的要求,也可以满足射频器件对于高导热和抗辐射 等需求,在电动车、新能源、通讯领域具有巨大的应用前景。
碳化硅作为衬底材料,由于自身硬度高、加工难度大,采用传统的刀轮切割技术,面临着加工效率低、环境负担重、材料 损耗大等问题,导致生产成本高,价格昂贵,难以大规模应用。
半导体材料常见类型
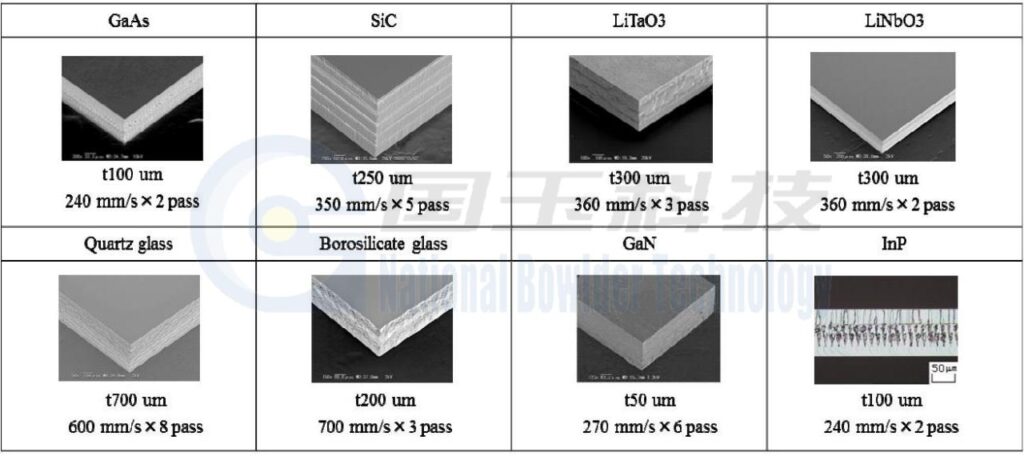
加工原理与流程

激光加工的优势: 非接触式加工,加工图案灵活,无应力破坏,可实时切换;
高速异形切割,划线速度可达到300mm/s,综合效率极高;
激光加工没有耗材,无碎屑粉尘产生、激光器使用寿命达2万 小时或以上;
激光隐形切割没有材料去除,单片晶圆产晶粒比例高。



